台积电,颠覆封装?
近年来,人工智能已经完全点燃了GPU,并且作为其背后的支撑力量。台积电CoWoS封装技术也在蓬勃发展。
大家都知道,多年来,GPU绝对领先的英伟达一直是台积电的重要合作伙伴,但是 AI 在领域最初的热潮之后,NVIDIA 进一步加深了与台积电的合作。现在,双方的合作关系已经发展到一定程度。除台积电外,英伟达CEO黄仁勋甚至说,NVIDIA 别无选择,尤其是在那里 CoWoS 领域。"这个封装技术很先进,很抱歉,目前我们还没有别的选择。”黄仁勋说。
这项技术也给台积电带来了很多好处。有消息称,他们甚至超越了太阳和月光,成为世界上最大的测试玩家。然而,他们并没有停止,这几年企业的CoWoS产能也有了很大的扩张。与此同时,一些新的技术变化正在悄然发生。
CoWoS的演变瓶颈
在半导体行业观察之前的文章《疯狂的CoWoS》中,我们对台积电的CoWoS有着深刻的描述。但是在这里,我们应该注意一点,那就是英伟达在最新的Blackwelll。 更多的CoWoS将用于系列产品。-L 包装生产能力,降低 CoWoS-S 封装产能。
据路透社报道,黄仁勋在日月光科技子公司硅产品精密工业有限公司(SPIL)“随着我们进入Blackwell,我们将主要使用Blackwell,”在新闻发布会上举行的先进封装工厂正式启用。 CoWoS-L 封装。” ”“当然,我们仍然在生产。 Hopper 封装,Hopper 还可以使用封装 CowoS-S 封装。我们还将把 CoWoS-S 包装产能转化为 CoWoS-L 封装。所以,我们不是要降低产能,而是要提高产能。 CoWoS-L 包装能力。”
这一决定背后的一个重要原因是基于这一决定 Blackwell 架构的 B200和NvidiaB100 GPU 需要两个计算芯片,并且需要 10 TB/s 相互连接的带宽。而台积电的 CoWoS-L 该技术已经实现了这一点,该技术采用了局部硅互连 (LSI) 桥接装置及重分布层 (RDL) 有机中介层。
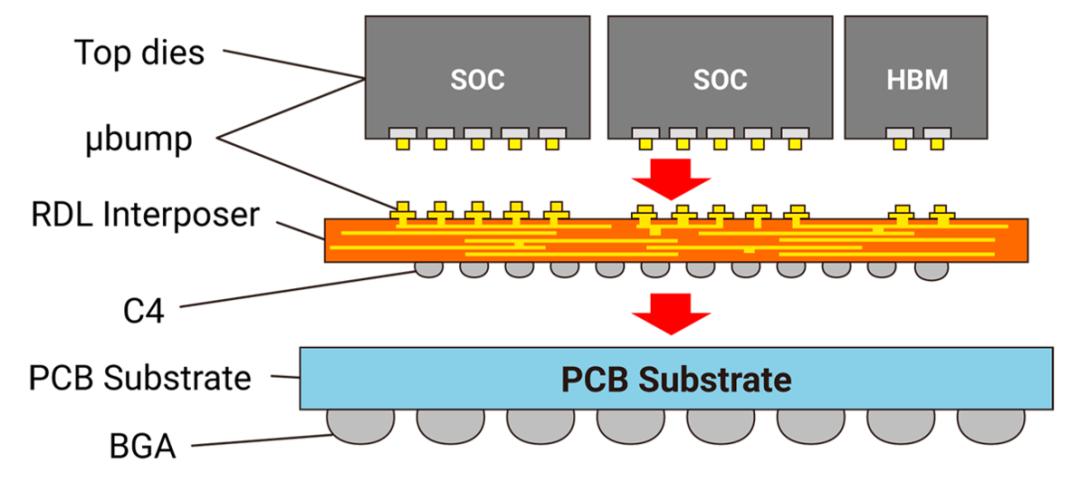
CoWoS台积电-L
但是,我们也必须认识到,随着芯片尺寸的不断增加,例如 AI 可以实现芯片尺寸 80x84 mm,一块 12 这种芯片只能容纳四个英尺晶圆。另外,超大型CoWoS封装面临着与基板尺寸和排热相关的考验。例如,5.5倍光罩的版本需要100x100毫米的基板,而9倍光罩的版本则超过120x120毫米。大型基板将影响系统设计和数据中心设备,尤其是在电源和制冷系统方面。就功耗而言,高性能处理器每个机架的功耗可达数百KW,这使得液冷和浸入式冷却技术能更有效地管理排热。
同时,台积电过去也在CoWoS中使用助焊剂。助焊剂的作用是提高连接芯片与中介层微沉孔的附着力,防止形成氧化膜,降低键合质量。然而,CoWoS 逐渐演变成一个使用助焊剂越来越困难的环境。沉孔键合后必须清除(清洗)助焊剂,但随着中介层尺寸的增大,在中心积聚的助焊剂很难完全清除。若有助焊剂残留,可影响芯片的稳定性。
事实上,台积电也专注于解决这一问题。
例如,据报道,台积电正在积极探讨无助焊剂键合技术在CoWoS中的应用。报告指出,台积电去年在提高CoWoS良率方面遇到困难后,不得不专注于替代技术,包括无助焊剂键合。
半导体行业人士此前透露,“台积电现在正在进口少量无助焊剂键合机,并在R&D阶段进行评估”,“我们预计今年年底将完成测试”。
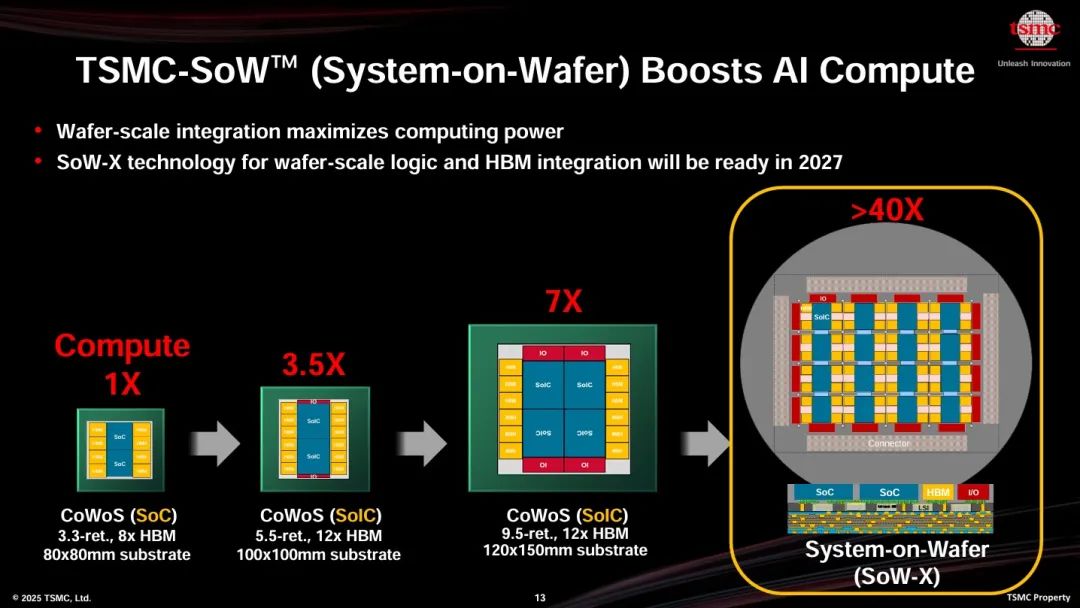
就中介层的尺寸而言,截至 2023 年,台积电 CoWoS 中介层在封装中的宽度是 80x80mm。大概比光罩大 3.3 倍。根据台积电计划,到2026年,将推出具有台积电的计划。 5.5 双掩模尺寸 CoWoS-L 。有创纪录的 9.5 双掩模尺寸,集成 12 HBM 堆栈的 CoWoS 也有望于 2027 年推出。另一种叫SoW的台积电路线图-X (System-on-Wafer)的技术,与 CoWoS 与之相比,它的性能得到了提高 40 倍,模拟完整的服务器机架功能,计划在服务器机架上。 2027 实现年度量产。
然而,这并没有缓解每个人的焦虑,这正是FOPLPLP。(Fan-out panel-level packaging)最近半年被提及的原因之一。我们还在之前的文章《FOPLP袭击,CoWoS压力暴增》中介绍了这一点。相关报道还指出,台积电在这项技术上也有布局。
不过最近,另一则新闻透露,台积电将对CoPoS技术进行下注,并计划下注。 2029 每年实现量产。而且英伟达,有望成为他们的第一个顾客。
颠覆传统中介层
CoPoS是Chip-on-Panel-on-相比之下,CoWoS是Substrate的缩写,Chip-on-Wafer-on-Substrate。整个命名过程都可以看到,就是中间的这个wafer换成了panel。
就技术而言,CoPoS 本质上就是把中介层“面板化”,建立所谓的面板。 RDL(重分布层),或将芯片放在“面板级别” RDL “层”上。即使是这样 510x515 mm面板,还可以容纳数倍于数倍的面板 300 芯片数量为mm晶圆。
就台积电而言,CoPoS本质上是CoWoS-L和CoWoS-L。CoWoS-R的方形面板演变,用矩形基板代替传统的圆形晶圆。据悉,矩形设计尺寸为310x310mm,比传统圆形晶圆提供了更大的可用基板空间,从而提高了产量效率,降低了成本。
根据台湾媒体报道,台积电位于嘉义。 AP7 工厂正逐步成为下一代先进封装的关键枢纽。该工厂计划分八个阶段进行建设,并将在第四阶段开始大规模生产 CoPoS。台湾媒体进一步报道,AP7 第一阶段(P1)将作为苹果的特殊用途。 WMCM(多芯片模块)基地,而第二阶段和第三阶段则致力于改进 SoIC 的产量。值得注意的是,该报告称,AP7 没有计划生产 CoWoS,而是要保留在这里 AP8,该厂由群创光电的旧厂改造而成。
聪明的你一定会发现,不管是FOPLP还是COPOS,都与面板有关,那么这两者又有什么不同呢?
第一,如上所述,FOPLP(扇形面板级封装)和 CoPoS(基板上面板芯片封装)全部采用大面板基板封装。然而,它们在架构和应用上存在着显著的差异,尤其在中介层面。(interposer)使用方面。FOPLP 这是一种不需要中介层封装的方法,芯片直接再次分布在面板基板上,并通过重分布层进行封装。 (RDL) 进行互连。这种方法成本低,I/O 具有密度高、尺寸灵活等优点,适合边缘 AI、中端移动终端和集成密度适中 ASIC 等应用。
相比之下,CoPoS 利用中介层,可以实现更高的信号完整性和稳定的功率传输——它集成了多个高性能、高功率芯片(例如 GPU 和 HBM)时间非常重要。中介层的出现 CoPoS 高端数据传输更适合需要大规模封装和高速数据传输的高端。 AI 和 HPC 系统。
另外,据了解。CoPoS 中介材料正从传统的硅转变为玻璃,从而提供更高的成本效率和热稳定性。
数据显示,与传统有机基板相比,玻璃芯基板具有更好的互连密度、更灵活的信号线路和更少的信号线路。 RDL 层数、较高的带宽密度和较低的一次数据传输功耗。特别值得注意的是,选择 TGV(玻璃埋孔)技术,消耗极小,而且材料的平面度,CTE(热膨胀系数)、刚度,吸水,传热等特性都比较理想。另外,它还具有优良的机械和电气特性,以及光传输应用的潜力。
它也是台积电的将军 CoPoS 定位为未来 CoWoS-L 其中一个潜在的替代品。据悉,未来CoPoS封装市场将锁定AI等高级应用,其中选择CoWoS-R制程的锁定博通,CoWoS-L是英伟达和超微的目标服务。
据业内分析,CoPoS在AI中放弃了传统的圆形晶圆,将芯片直接排列在大型方形面板基板上,大大提高了产能和面积利用率。CoPoS的封装结构更具弹性,适合多样化芯片的尺寸和应用需求。、在高效率计算领域,5G具有很强的竞争力。
写在最后
虽然有很多好处,但是我们要明白,如果一项看上去不错的技术还没有普及,那一定是因为它还有一些缺点还没有得到客户的认可。
例如,从圆形封装技术到方形封装技术的转变,需要投入大量的材料和设备研发。为了实现高精度的导体图案,需要克服翘曲、匀称等问题,因为这将是良率的挑战。此外,客户对RDL 线距/间隔要求为10。µm 缩小到 5µm,甚至 2µm、1µm,这就要求供应商在RDL 在布局上取得新的突破。
总而言之,未来是可以期待的,仍然需要努力。
本文来自微信公众号“半导体行业观察”(ID:icbank),作者:穆梓,36氪经授权发布。
本文仅代表作者观点,版权归原创者所有,如需转载请在文中注明来源及作者名字。
免责声明:本文系转载编辑文章,仅作分享之用。如分享内容、图片侵犯到您的版权或非授权发布,请及时与我们联系进行审核处理或删除,您可以发送材料至邮箱:service@tojoy.com




