博通推出了3.5个芯片面积的4个H200,D XDSiP封装平台
电子爱好者网报道(文章 / 博通最近推出了梁浩斌 3.5D XDSiP 面向下一代高性能的芯片封装平台技术 AI、HPC 应用的定制 XPU 和 ASIC。3.5D XDSiP 最大的亮点,就是能超越它。 6000 平方毫米的 3D 把硅片和硅片堆起来 12 个 HBM 将模块集成到系统级封装中。这个概念是什么?
骁龙手机移动终端旗舰处理器 8Elite 核心面积是 124.1 平方毫米;英伟达 H200 核心面积 1526 平方毫米;英伟达今年首次推出 Blackwell 架构 GPU B200,采用双 die 封闭,核心面积也达到了 1600 上下平方毫米。换言之,博通 3.5D XDSiP 平台,可以支持近距离 4 个 B200 集成在一个封装中的核心。
所以如此“巨大”的芯片是如何包装的,市场上真的需要如此大规模的芯片吗?
2.5D 封装、3D 堆栈、F2F 第一批商品堆叠结合 2026 上市
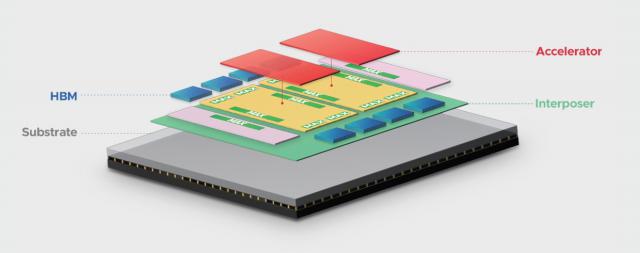
在大规模计算集群中,随着摩尔定律的进一步缓解,先进封装 XPU 世界范围内的应用已成为行业共识, AI 计算中,XPU 需要计算、内存、I/O 等待复杂的功能集成,以最大限度地降低功耗和支出。
而博通的 3.5D XDSiP 作为一个用于定制计算芯片的平台,平台的优势主要包括:
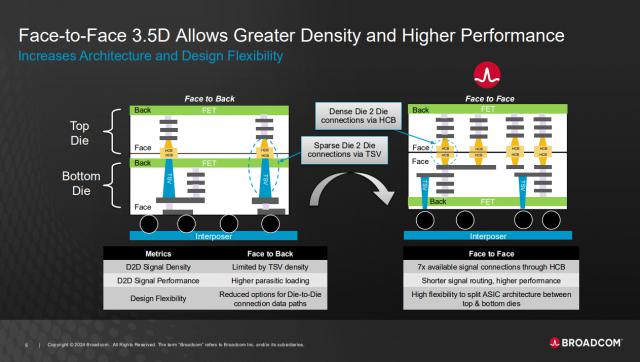
加强互连密度:与传统选择硅通孔 TVS 的 F2B相对于3.5的技术(面到背)D XDSiP 选用 HCB(混合铜键合)以 F2F逻辑芯片以零距离的形式堆叠,增加了堆叠芯片之间的信号密度。 7 倍;
高能效率:通过使用 3D HCB 取代平面芯片到芯片的物理接口,减少芯片到芯片接口的功耗 90%;
减少延迟:最大限度地减少延迟 3D 计算、内存和堆栈 I/O 零件间延迟;
超小型化:支持较小的转接板和封装尺寸,从而降低成本,改善封装翘曲。
这种封装技术是博通多年来与台积电合作的结果, ASIC 产品部高级副总裁兼总经理 Frank Ostojic 表示:“随着我们达到摩尔定律的极限,对下一代来说,先进的封装是 XPU 集群尤为重要。通过与客户的密切合作,我们在台积电和台积电。 EDA 在技术和工具的基础上,合作伙伴创造了一个 3.5D XDSiP 平台。芯片组件通过垂直堆叠,Broadcom 的 3.5D 该平台使芯片设计师能够在缩小插入器和包装尺寸的同时,为每个部件匹配正确的制造工艺,从而显著提高性能、效率和成本。"
台积电市场拓展高级副总裁张晓强博士表示,台积电和博通近几年密切合作,处理和处理台积电最先进的逻辑 3D 与博通设计专业知识相结合的芯片堆叠技术。
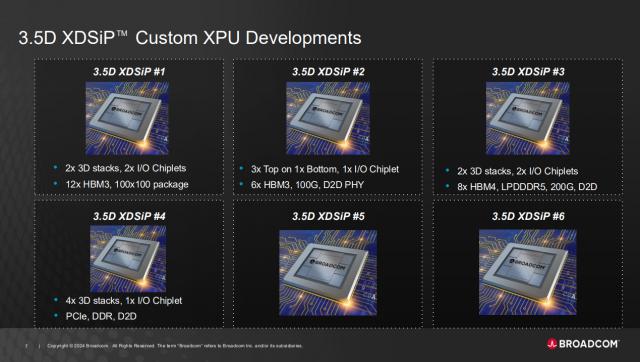
博通说,3.5D XDSiP 现在技术已经成为主要技术 AI 客户已经使用了领域, 6 该产品正在开发中。在这些人中,富士通下一代 2nm 制程的 Arm Cpu FUJITSU-MONAKA 已确认使用博通 3.5D XDSiP 根据富士通之前的介绍,技术,这个Cpu面向数据中心,边缘计算等应用,MONAKA 每粒 CPU 包含一个中心 I/O die 和四个 3D 竖直堆叠 die,并集成 SRAM,预估 2027 年出货。
使用 3.5D XDSiP 博通最早预测技术芯片产品。 2026 年 2 每月实现出货。
总结
作为未来的先进封装 AI 计算芯片的重要组成部分,博通,一个大面积的芯片封装方案,可以大大提高系统集成度。同时,通过创新的互联方案,可以提高电影中互联的带宽和能效,有望成为未来高性能处理器的重要方向。
阅读更多热门文章
加关注 星标我们
把我们设为星标,不要错过每一次更新!

喜欢就奖励一个“在看”!
本文仅代表作者观点,版权归原创者所有,如需转载请在文中注明来源及作者名字。
免责声明:本文系转载编辑文章,仅作分享之用。如分享内容、图片侵犯到您的版权或非授权发布,请及时与我们联系进行审核处理或删除,您可以发送材料至邮箱:service@tojoy.com





