写给小白的芯片封装入门科普
从今天开始,我们就来谈谈芯片封装和测试(通常简称“封装测试” )。

这个部分,在业界也被称为后道。( Back End)工艺,通常由OSAT封装测试厂组成(Outsourced Semiconductor Assembly and Test,负责包装半导体封装和测试)。
封装的目的
先讲封装。
事实上,每个人都经常听到“封装”这个词。这主要是指将晶圆上的裸芯片(晶体)转化为最终成品芯片的过程。

为什么要做封装,主要有两个目的。
一是保护弱晶体,避免物理磕碰损伤,同时防止软晶体受损。 气体中的杂质 腐蚀晶体的电路。
第二,使芯片更加适应使用场景的需要。
芯片的使用场景很多。不同的场景对芯片的外观有不同的要求。适当的包装可以使芯片工作得更好。

在日常生活中,我们会看到许多外观的芯片,实际上是不同类型的封装。
包装开发阶段
随着芯片的出现,封装工艺至今已有70多年的历史。
总体而言,封装工艺共经历了五个发展阶段:

下一步,我们一个接一个地说。
传统封装
最早的晶体管,采用TO(晶体管封装)。此后,DIP发展起来( 双排直插封装)。

TO封装是我们最熟悉的三极管造型。
再之后, SOP是由PHILIP公司开发的(小外观) 封装 ),并且逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小的外形封装)、VSOP(甚小的外形封装)、SSOP(缩小SOP)、TSSOP(薄型SOP)和SOT(小型晶体管)、SOIC(小型集成电路)等。

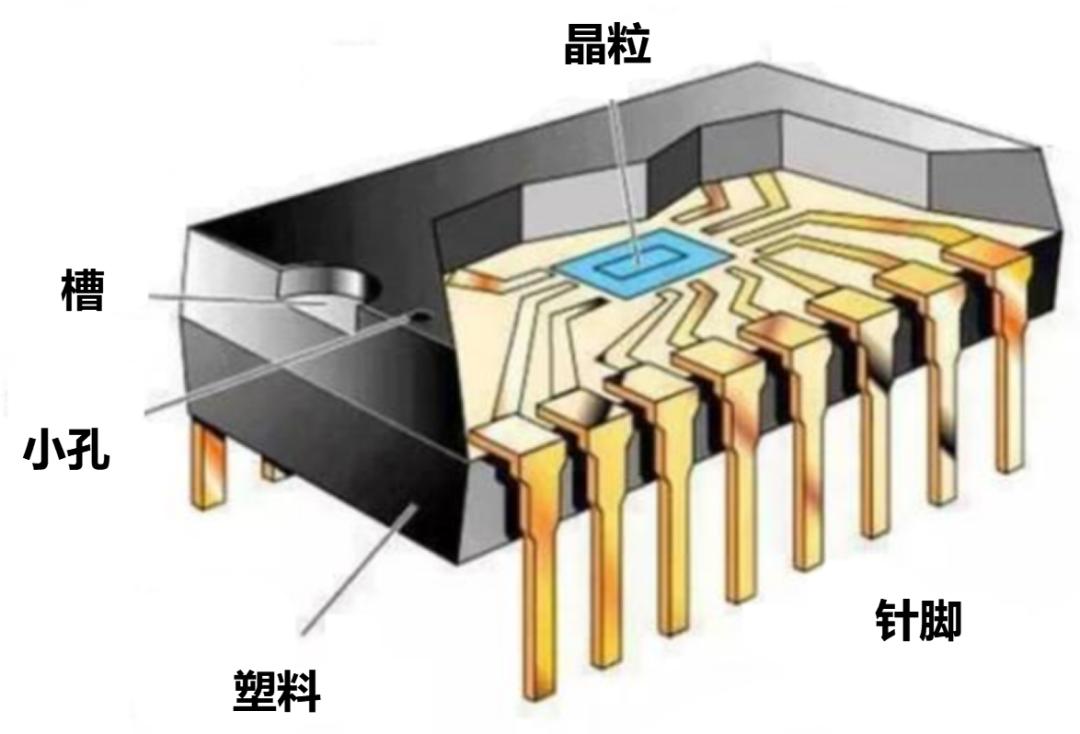
内部结构DIP
一、二阶段(1960-1990年)封装,采用埋孔插装式封装类封装。(THP)以及表面贴装类封装(SMP)为主, 属于传统封装。
常规封装,主要依靠导线将晶体与外界建立电气连接。
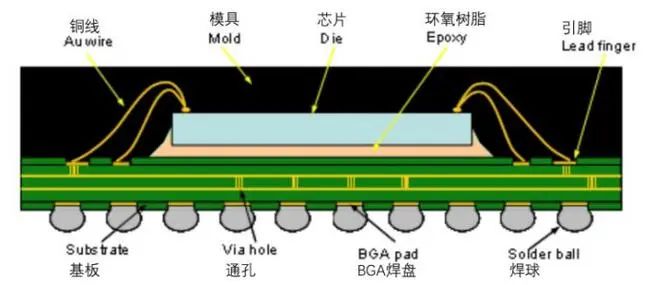
到目前为止,这些传统包装仍然相当普遍。特别是一些老式的经典芯片,对性能和体积要求较低,仍然会采用这种低成本的包装方式。

第三阶段(1990-2000年),随着IT技术革命的加速普及,芯片功能越来越复杂,需要更多的针角。电子设备微型化,芯片体积需要继续缩小。
这时, BGA( 球型矩阵、 球栅阵型) 包装开始出现,成为主流。
BGA仍然是一个传统的包装。其接脚位于芯片下方,数量众多,尤其适用于需要大量接触的芯片。此外,与DIP相比,BGA体积更紧凑,特别适合需要微型设备。

BGA封装
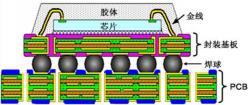
内部BGA封装
与BGA有些相似,还有LGA(平面网格列阵封装 )和PGA( 插针网格列阵封装)。每个人都应该注意到,我们最熟悉的CPU,就是这三种封装。

先进封装
20世纪末,芯片级封装( CSP)、晶圆级封装(WLP)、 倒装封装 (Flip Chip )开始逐步崛起。传统的封装逐渐演变成先进的封装。
与BGA这种封装相比, 芯片级封装( CSP)更加注重尺寸的微型化(包装面积不超过芯片面积的1.2倍)。
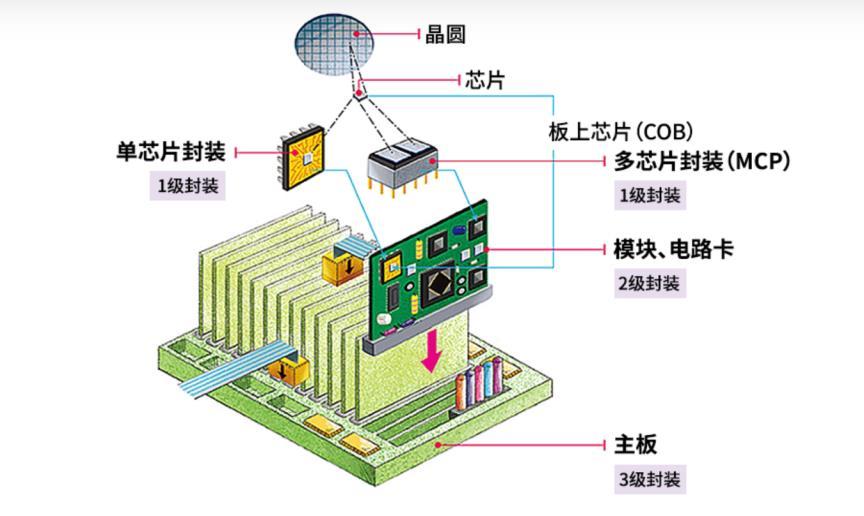
包装级别(来自) Skhynix)
晶片级封装是一种芯片级封装,封装尺寸接近裸芯片大小。
下一期我们讲具体工艺时,会提到封装涵盖了一种切割工艺。 传统的封装,首先要切割晶圆,然后再封装。而且晶圆级封装,首先要封装,然后切割晶圆,工艺不同。
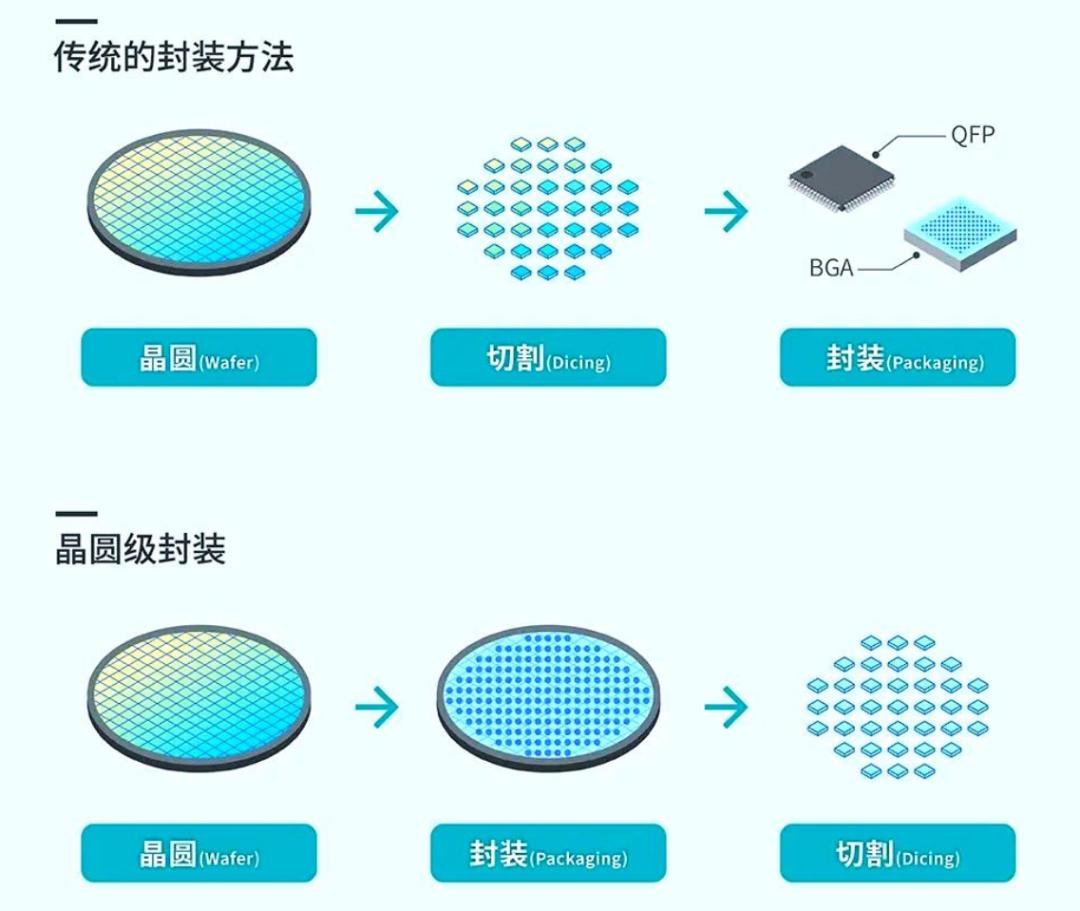
晶圆级封装
倒装封装 (Flip Chip )这是一项早期发明。IBM在20世纪60年代创造了这项技术。但直到20世纪90年代,这项技术才开始普及。
选择倒装封装,即不再用金属丝连接,而是将晶圆直接反过来,通过晶圆上的突点。( Bump),电气连接到基板上。
与传统的金属丝法相比,倒装封装的I/O(输入/导出)通道数量较多,互连长度缩短,电气性能较好。另外,在散热和封装尺寸方面,倒装封装也有优点。

高级封装的出现,迎合了当时时代发展的需要。
采用先进的设计与工艺,对芯片进行封装级重构,带来更多的引脚数量,体积更小,系统集成度更高, 系统的性能可以大大提高。
进入21世纪后,随着移动通信和互联网革命的进一步爆发,芯片封装进一步向高性能发展, 小型化、低成本、高可靠性等方面的发展。先进的封装技术正式进入快速发展阶段。
在此期间,芯片内部布局开始从二维到三维空间的发展(将多个晶体塞在一起),接连出现 2.5D/3D封装、 硅通孔(TSV)、重布线层(RDL)、扇入(Fan-In)/扇出(Fan-Out)晶圆级封装,系统级封装,(SiP)等待先进技术。
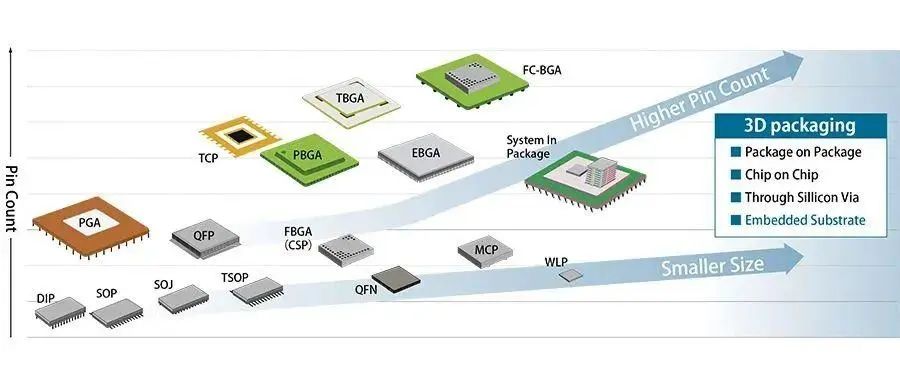
随着芯片工艺的发展逐渐触及摩尔定律的底线,这些先进的封装技术,成为持续摩尔定律的“救命稻草”。
先进封装的核心技术
2.5D/3D封装
2.5D和3D封装,都是对的, 对芯片进行堆叠封装。
2.5D封装技术,可将两种或两种以上的芯片放入单个封装,同时使信号横着传输,这能提高封装的尺寸和性能。
最为广泛使用的2.5D封装方法是通过硅中介层进行封装( Interposer)将内存和逻辑芯片(GPU或CPU等)放入单个封装中。
硅通孔需要使用2.5D封装(TSV )、重布线层(RDL )、核心技术,如微型沉孔。
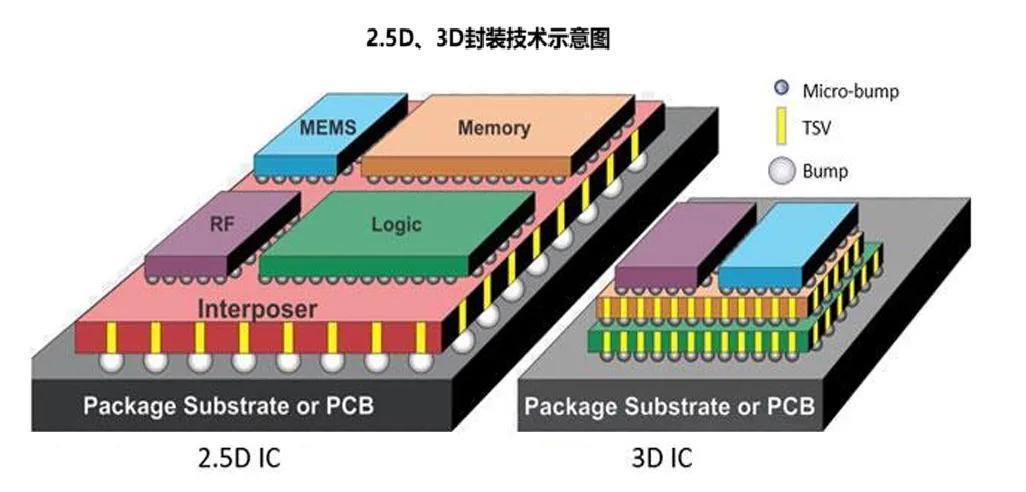
3D封装位于同一封装体内,竖直方向多种芯片封装技术的叠放。
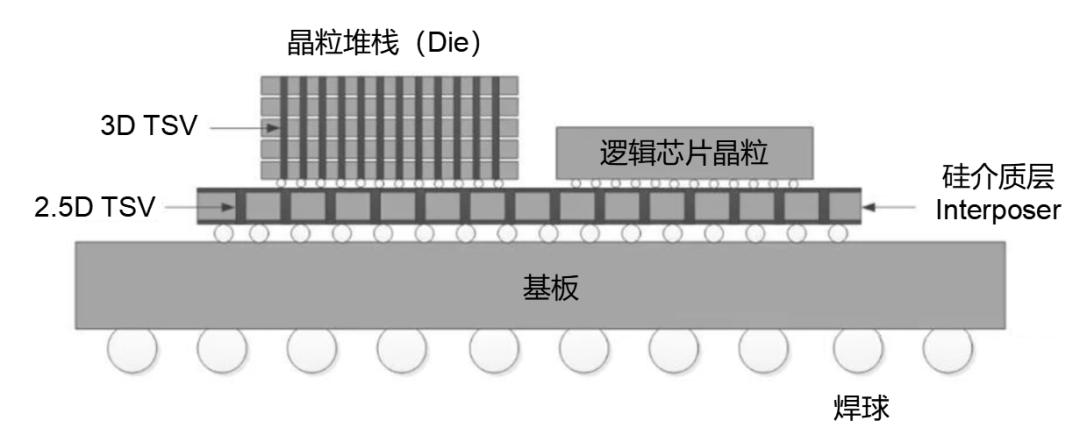
2.5D和3D封装的主要区别在于:
2.5D封装,是在Interposer中进行布线和打孔。而且3D封装,就是直接从芯片上打孔和布线,连接上下芯片堆叠。相对而言,3D封装要求更高,难度更大。
FLASH存储器2.5D和3D封装起源(NOR/NAND )需要SDRAM。著名的HBM(High Bandwidth Memory, 高带宽存储器), 典型的2.5D和3D封装应用。整合HBM和GPU,可以进一步发挥GPU的性能。

HBM,对GPU非常重要,对AI也非常重要。
通过硅通孔等先进的封装工艺,HBM将多个DRAM垂直堆叠,并将GPU封装在Interposer上。HBM内部的DRAM堆叠,属于3D封装。而且HBM和GPU封装在Interposer上,属于2.5D封装。
现在业内许多厂商都推出了新技术,例如 CoWoS、HBM、Co-EMIB、HMC、Wide-IO、Foveros、SoIC、X-Cube等,都是由 从2.5D和3D封装演变而来。
系统级封装(SiP)
每个人都应该听说过SoC (System on Chip, 系统级芯片)。SoC芯片是我们手机中的主要芯片。
SoC,简单来说,就是在一个单一的芯片中整合设计几个功能不同的芯片。这样可以最大限度的缩小体积,实现高度集成。
但是,SoC的设计非常困难, 与此同时,还需要获得其它制造商的IP(intellectual property)授权,增加成本。
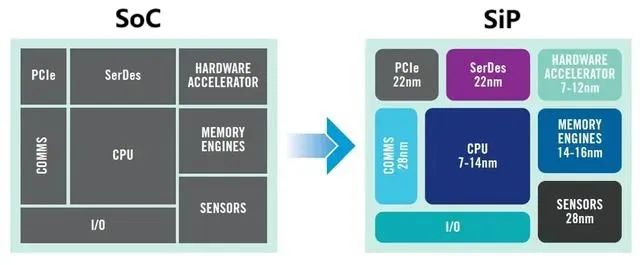
SiP(System In Packet,与SoC不同的是,系统级封装。
SiP直接使用多个芯片, 并列或叠加方式(2.5D/3D封装),封装在一个单一的封装体内。
尽管SiP的集成度没有SoC高,但是也足够了,还可以减小尺寸,主要是更加灵活,成本更低。( 避免了繁琐的IP授权步骤)。
Chiplet(业内常说的) 芯片,小芯片),实际上是SiP的想法, 一种符合特定功能的裸片类型( die),通过die-to-内部互联技术die,互联形成大芯片。
硅通孔(TSV)
前面反复提到硅通孔。( through silicon via,TSV,又叫硅穿孔 )。
所谓的硅通孔,其实原理也很简单,就是在硅介质层上 蚀刻垂直埋孔,并填充金属,实现上下两层的垂直连接,从而实现电气连接。
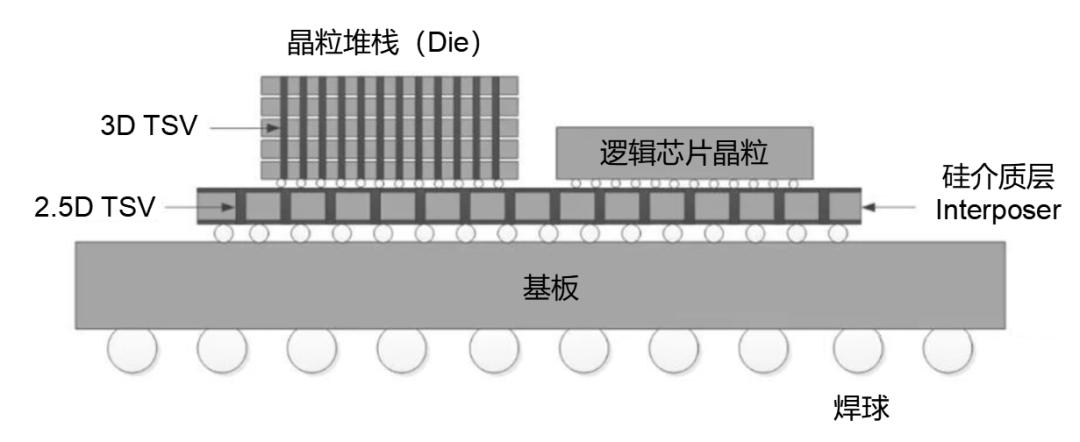
由于垂直互连线的距离最短,强度更高,硅通孔可以更容易地实现微型化、高密度、高性能等优点,特别适合叠加封装(3D封装)。
下次我们将介绍硅通孔的实际工艺。
重布线层(RDL)
RDL是将金属层和相应的介电层沉积在芯片表面,形成金属导线,重新设计IO端口到一个新的、更宽敞的区域,形成表面阵型布局,实现芯片与基板的连接。
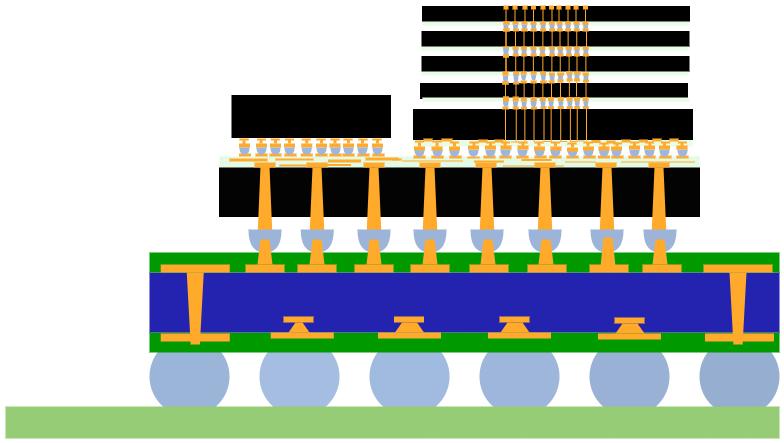
RDL技术
说白了就是再次连接硅介质层,保证上下两层的电连接。在3D封装中,如果不同类型的芯片堆叠在上下(接口不对齐),则需要通过 RDL重布线层,对准上下芯片IO。

假设TSV完成了Z平面的延伸,那么,重布线层(RDL)该技术完成了X-Y平面的延伸。WLCSPP等行业的许多技术、FOWLP、INFO、FOPLP、以RDL技术为中心的EMIB等。
扇入(Fan-In)/扇出(Fan-Out)晶圆级封装
WLP(晶圆级封装)可分为扇入型晶圆级封装(Fan-In WLP)和扇形晶圆级封装(Fan-Out WLP)两大类。
风扇直接从晶圆中封装,封装后切割,走线全部在芯片尺寸内进行,封装尺寸与芯片尺寸相同。
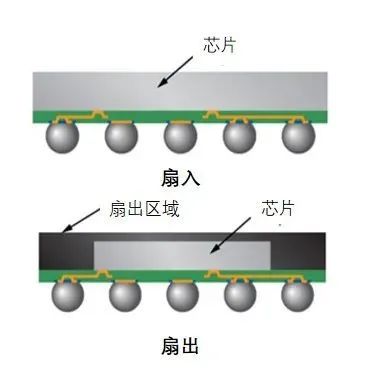
扇形是基于晶圆重构技术,切割后的芯片再次布局在人工载板上。然后,进行晶圆级封装,最后切割。在芯片内部和芯片外部,可以获得的封装面积一般大于芯片面积,但可以提供的IO数量增加。
扇出型产品是目前量产最多的产品。
上面,小枣君尽量简单地介绍一些封装背景知识。
下一期,我将开始介绍封装的主要工艺。请注意!
参考文献:
1、半导体封装工程师世家《芯片制造全过程》;
2、《 一篇文章阅读芯片生产过程,Eleanor羊绒衫;
3.、《 要看芯片制造的全过程,射频学校;
4、《 先进封装是什么?与传统封装有何不同?怎样分类?” 赵工失效分析工程师;
5、《 本文了解了先进封装的倒装芯片(FlipChip)技术》, 圆圆的,半导体全解;
6、《 本文了解硅通孔(TSV)及玻璃通孔(TGV)技术,圆圆的,半导体全解;
7、《 国金证券、国金证券、国金证券、国金证券、国金证券等先进封装发展的条件已经具备;
8、《 民生证券,Chiplet先进封装大放异彩;
9、维基百科,百科,各厂商官网。
本文来自微信微信官方账号“鲜枣课堂”(ID:xzclasscom),作者:小枣君,36氪经授权发布。
本文仅代表作者观点,版权归原创者所有,如需转载请在文中注明来源及作者名字。
免责声明:本文系转载编辑文章,仅作分享之用。如分享内容、图片侵犯到您的版权或非授权发布,请及时与我们联系进行审核处理或删除,您可以发送材料至邮箱:service@tojoy.com






