最新的芯片封装专利华为公布:可以提高芯片焊接的优良率
快科技 11 月 17 今天在国家知识产权局官网查询,发现华为科技有限公司近日公布了一项名为“芯片封装结构、电子产品和芯片封装结构制备技术”的专利,并授权公告号 申请日期为CN116250066B 2020 年 10 月。
该申请实施例涉及芯片封装技术领域,提供芯片封装结构、电子产品和芯片封装结构的制备工艺,旨在提供能够准确控制胶层厚度和尺寸的芯片封装结构。
据报道,由于高速数据通信和人工智能对计算能力的需求激增,芯片集成度进一步提高。其中,多芯片封装技术在芯片尺寸变大的同时得到广泛应用,使得整个芯片封装结构的尺寸不断增加。
随着芯片封装结构尺寸的增加,芯片与封装基板之间的热膨胀系数不匹配,封装热膨胀的控制将变得越来越困难,封装热膨胀的增加将直接导致整个芯片封装结构的大翘曲。
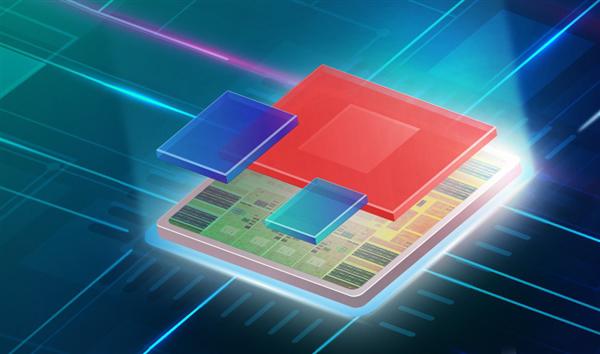
据了解,在华为申请实施例提供的芯片封装结构中,由于多个限位块的任意限位块厚度等于粘接层的厚度,在制备过程中,在封装基板上设置多个限位块,然后涂胶,再封装加固结构,使加固结构面向封装基板的表面与多个限位块相连。
加固结构的位置受到限位块的限制,从而准确控制粘接层的厚度和尺寸。如果限位块的厚度与粘接层的厚度设计值相同或相近,最终封装形成的粘接层的厚度将与设计值相同或相近。
在保证封装内应力小的同时,兼顾翘曲水平不能太大,然后将芯片封装结构和 PCB 焊接时,可以提高焊接优良率。
同时,在批量包装相同规格的芯片封装结构时,可以实现产品结构的统一,不会出现一些粘接层较厚、一些粘接层较薄的现象。

本文仅代表作者观点,版权归原创者所有,如需转载请在文中注明来源及作者名字。
免责声明:本文系转载编辑文章,仅作分享之用。如分享内容、图片侵犯到您的版权或非授权发布,请及时与我们联系进行审核处理或删除,您可以发送材料至邮箱:service@tojoy.com


