【复材资讯】北科大科研新突破登Science!
01【科学背景】
自硅基晶体管逼近物理极限,原子级薄的过渡金属硫族化合物(TMDs)被视作“后摩尔”时代理想的沟道替代材料。它们具备1.2–1.8eV的可调带隙、原子级锐利的界面以及优异的静电控制能力,能将栅长压缩至10nm节点以下。
然而,当工业尝试将TMD从实验室引入晶圆厂时,金属 - 半导体接触成了难题。传统硅工艺依靠金属硅化物与硅形成强共价键,接触电阻低至20–50Ω·μm,还能承受400°C后端制程(BEOL)而不退化。但TMD表面只有范德华力,无悬挂键且被硫族原子“钝化”,金属沉积后只能形成弱范德华(vdW)搭接,带来诸多问题:一是隧穿势垒厚达1nm、高度>0.3eV,电子注入效率大幅下降,接触电阻普遍>500Ω·μm;二是界面粘附能仅0.05eVÅ - 2,高温退火时金属再结晶、球化,沟道会被拉裂;三是热 - 电耦合失效,器件在300°C时性能衰减>50%。
过去十年,科研界尝试了边缘接触、半金属Bi/Sb、相变界面等方案,虽将电阻降至100Ω·μm量级,但在BEOL热预算下仍失败。如何像硅化物那样在原子尺度固定金属与TMD,成为二维电子学能否进入5nm以下技术节点的关键。
02【创新成果】
近期,北京科技大学张跃院士、张铮教授和张先坤教授联合首创“原子层键合(ALB)”工艺。该工艺利用超软氩等离子体选择性剥除单层MoS2表面硫原子,暴露的Mo原子层因失配应力自发收缩6%,与Au(111)晶格失配从8%骤降至<0.3%,形成金属 - 金属共格界面。此界面键合能提升至0.28eVÅ - 2,是vdW的5.4倍,载流子隧穿势垒接近0eV,首次同时实现70Ω·μm接触电阻、400°C热稳定性及1.1mA·μm - 1饱和电流,全面满足2028年IRDS高性能逻辑需求,且在WS2、MoSe2等多层二维半导体中验证了通用性,为二维集成电路从“实验室到晶圆厂”扫除了最后障碍。

03【图文解析】

图1、ALB接触与vdW接触的比较。

图2、MoS2与金电极之间ALB合金接触的实现。

图3、ALB接触的电子特性。
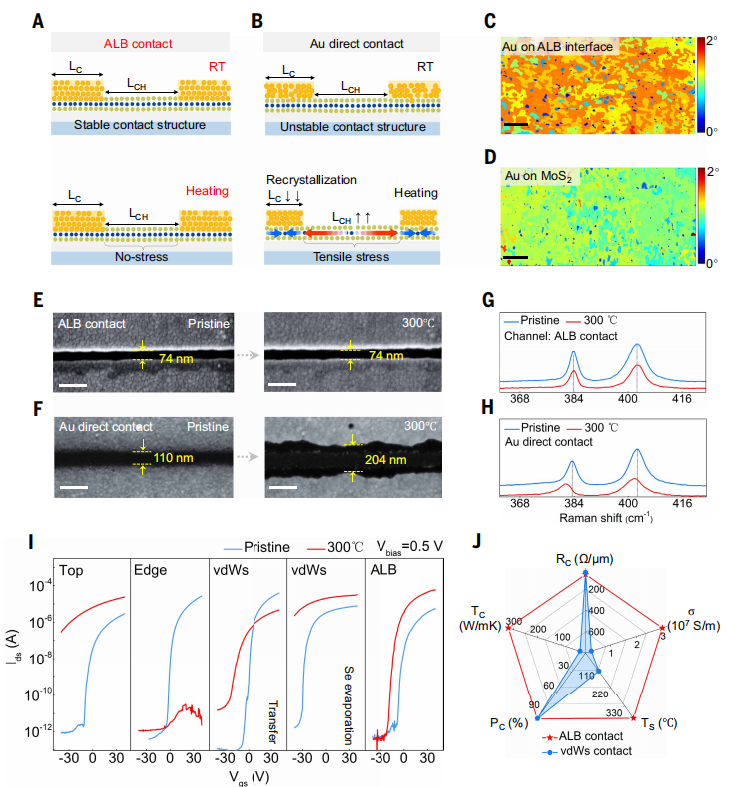
图4、铝基复合材料接触面的增强热机械稳定性。
04【科学启迪】
综上所述,本文通过建立金属相干结合界面,成功实现了二维过渡金属二硫化物半导体与金属之间的ALB接触。以“将范德华弱接触升级为金属共格强键合”的思路,破解了二维半导体电极的电阻和热稳定性双重瓶颈,展现了材料 - 工艺 - 器件协同设计的强大作用。其核心是“让界面自己长出匹配晶格”,利用TMD本征层间弱耦合,使过渡金属面在失配应力下主动收缩,与金属晶格自对准,把高能量垒的“隧道口”变为零势垒的“高速匝道”。ALB接触克服了范德华半导体的固有缺陷,提高了范德华电子器件的工业兼容性,有望推动二维电子器件从“实验室走向工厂”。
本文仅代表作者观点,版权归原创者所有,如需转载请在文中注明来源及作者名字。
免责声明:本文系转载编辑文章,仅作分享之用。如分享内容、图片侵犯到您的版权或非授权发布,请及时与我们联系进行审核处理或删除,您可以发送材料至邮箱:service@tojoy.com




