台积电北美技术研讨会,整个细节来了
当地时间4月23日,台积电在美国召开了“2025年北美技术研讨会”。台积电本次会议介绍了先进的技术发展和行业挑战和机遇,重点分析了半导体技术升级、先进的工艺路线图、下一代节点验证和晶体管架构和材料创新,旨在支持未来的智能计算基础设施。
下面是本次会议的重点内容。
AI和半导体市场
据台积电发布的最新消息,半导体产业正进入前所未有的扩张阶段,预计到2030年,全球半导体市场将达到1亿美元。促进这种增长最重要的因素是高性能计算(HPC)和人工智能(AI)应用爆发式发展。
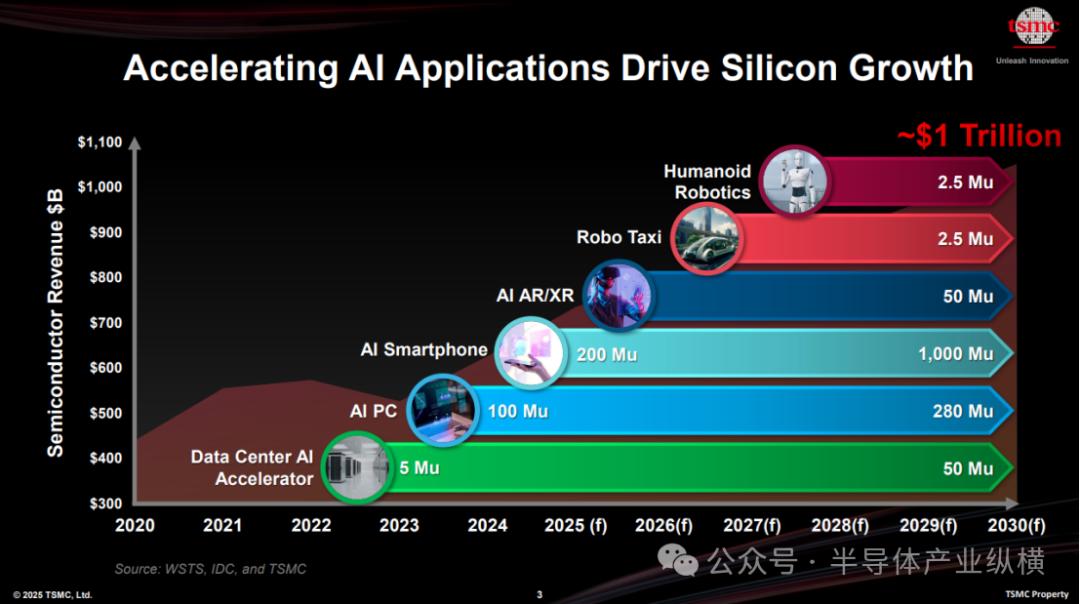
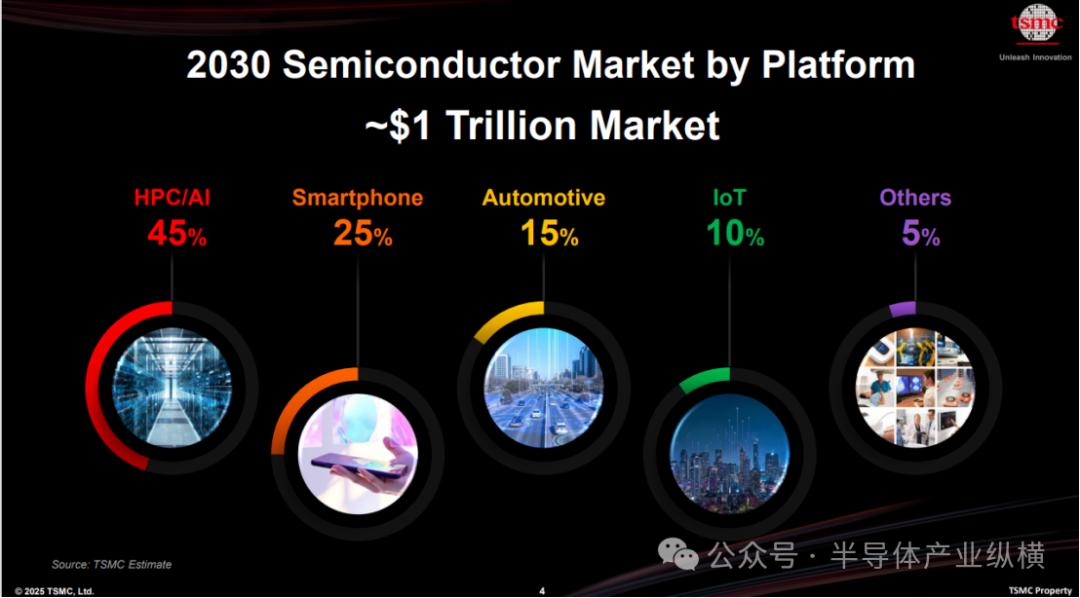
上面的图表显示了台积电的预测,到2030年,HPCAI将占全球半导体市场的45%,成为主导应用平台。其次是智能手机,占25%;15%的汽车电子占15%;物联网占10%;其他领域占5%。这种市场结构的变化表明,半导体市场正在从以移动终端需求为中心的创新驱动模式转变为以AI和高吞吐量计算工作负载为核心的创新驱动模式。
如何快速加快AI驱动的应用对半导体的需求?这种增长从数据中心的AI加速器扩展到AI个人电脑、AI智能手机、增强现实/虚拟现实。(AR/XR)机器人出租车和人形机器人等设备,以及更长期的应用。这类应用不仅数量不断增加,而且结构复杂性也不断提高。

具体来说,预计到2029年,AI个人计算机的出货量将达到2.8亿台,预计到2025年,AI智能手机的出货量将超过10亿部。预计到2028年,AR/XR设备的出货量将达到5000万台。
此外,预计到2030年,机器人出租车和人形机器人等下一代应用每年将需要250万个高性能芯片。这些数据表明,未来的芯片不仅要有更高的计算性能,还要在能源效率、系统级集成、封装密度等方面取得突破。
台积电认为,这些新的AI驱动应用将大大增加芯片的复杂性,对更密切的集成提出更高的要求,促进工艺创新,最终为半导体行业的新一轮增长增加动力。在台积电看来,这是实现半导体行业1亿美元愿景的基本途径。
先进工艺技术:N3、N2、A16、A14
N3
当前,台积电的N3系列(即3nm工艺)已经包含了已经量产的N3和N3E,并且计划后续推出N3P。、N3X、N3A和N3C版本。

台积电透露,本公司计划于2024年第四季度开始生产基于N3P(第三代3纳米)性能强化生产技术的芯片。N3P是N3E的后续产品,主要用于客户端和数据中心应用,需要提升性能,保留3纳米IP。
N3P是N3E的一种光学微缩工艺,它保留了设计规则和IP兼容性,同时在相同的漏电流下提高了5%的性能,或者在相同的频率下降低了5%到10%的功耗,而在典型的逻辑、SRAM和模拟模块混合设计中,晶体管密度提高了4%。由于N3P密度增益来源于优化的光学器件,它可以更好地扩展整个芯片结构,特别有利于SRAM的高性能设计的广泛应用。现在N3P已经投入生产,所以这家公司现在正在为其主要客户开发基于该研究的商品。
N3X有望在相同的功率下提高5%的最大性能,或者在相同的频率下降低7%的功耗。但是,与N3P相比,N3X的主要优点是它支持高达1.2V的电压(对于3nm级技术来说,这是一个极限值),这将提供绝对最大频率的应用程序(即客户端CPU)。(Fmax)。Fmax的代价是:漏电功率高达250%-因此,芯片开发者在构建基于N3X且电压为1.2V的设计时必须小心。N3X芯片有望在今年下半年实现量产。
台积电路线图有一些细微的变化。线路图已经延长到2028年,N3C和A14都有所提升。N3C是一个压缩版本,这意味着良率学习曲线已经到了进一步优化工艺密度的阶段。
台积电会披露了下一代芯片制造技术的进展。公司预计今年下半年将开始量产N2芯片。这是台积电第一次使用全围栏。(GAA)生产纳米片晶体管技术。
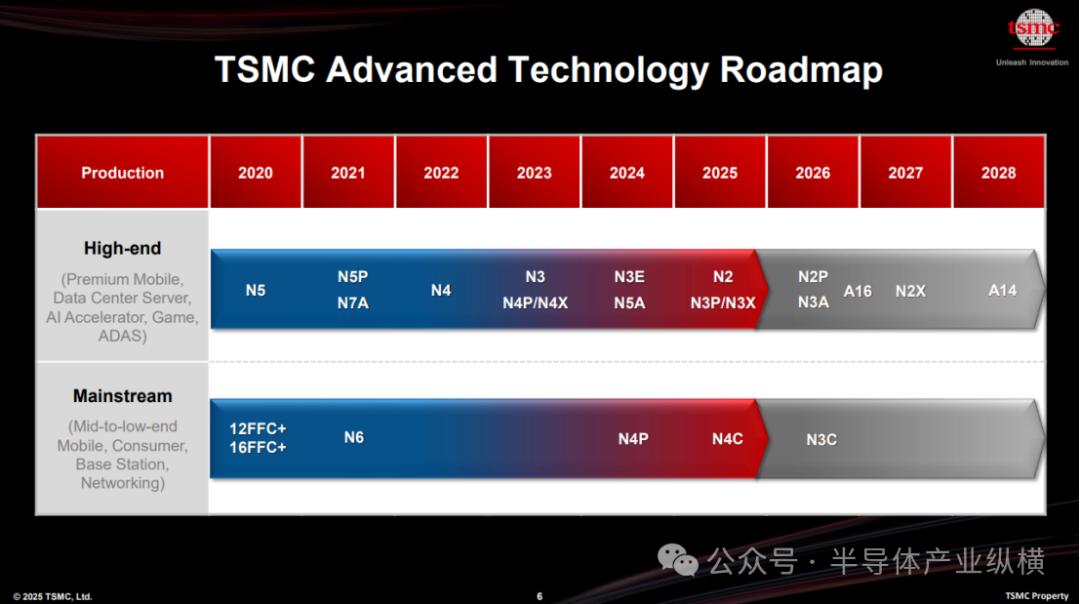
N2
作为台积电的全新生产工艺,N2(即2nm工艺)采用纳米片或围栏极设计。N2可以在相同的功耗下实现10%-15%的速度提升,也可以在相同的速度下降低20%-30%的功耗。


N2技术的性能比现有的N3E技术提高了10%-15%,耗电量降低了25%-30%,晶体管密度提高了15%。台积电还表示,N2的晶体管性能接近预期效果,256Mb SRAM模块的平均良率超过90%。随著N2逐步进入大规模生产阶段,其工艺成熟度将进一步提高。台积电估计,在智能手机和高性能计算应用的推动下,2nm技术的流片数量在投产初期将超过3nm和5nm技术。
另外,台积电继续遵循其技术改进策略,推出N2P作为N2系列的延伸。在N2的基础上,N2P进一步优化了性能和功耗,计划于2026年投入生产。台积电将在N2之后进入A16(即1.6)nm)节点。
A16
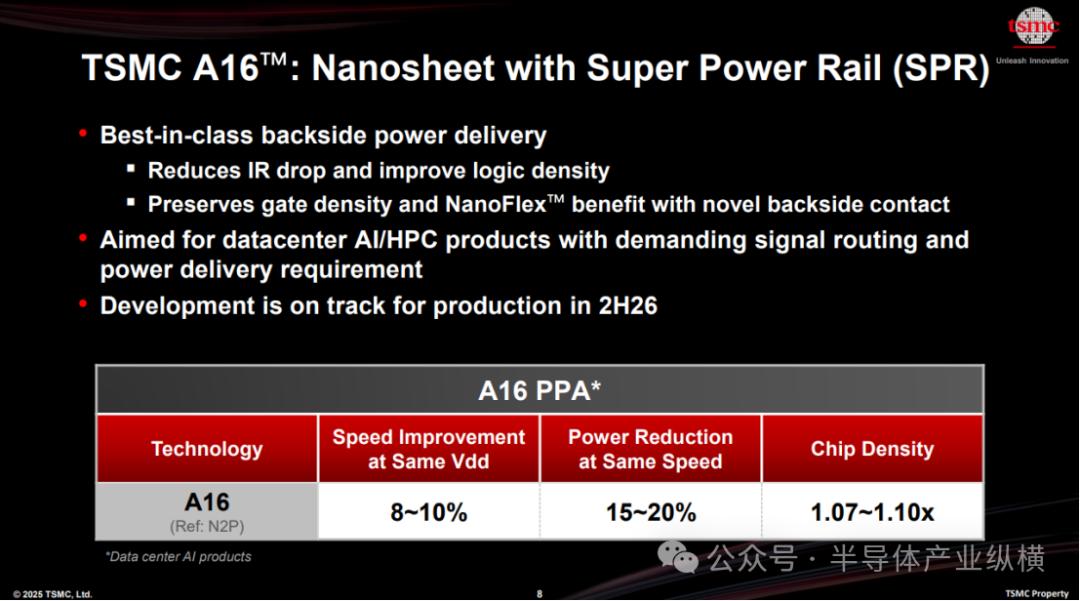
超级电轨架构,又称背面供电技术,是A16技术的关键技术特征之一。该技术可以释放更多的正面布局空间,从而提高芯片的逻辑密度和整体效率,从而将供电网络移至晶圆背面。根据台积电的说法,与N2P相比,A16可以在相同的电压和设计条件下提高8%-10%的性能;在相同的次数和晶体管数量下,功耗可以降低15%-20%,密度可以提高1.07-1.10倍。
台积电特别指出,A16技术特别适用于高性能计算,信号路由复杂,供电网络集中。(HPC)商品。按计划,2026年下半年,A16将开始大规模生产。
A14
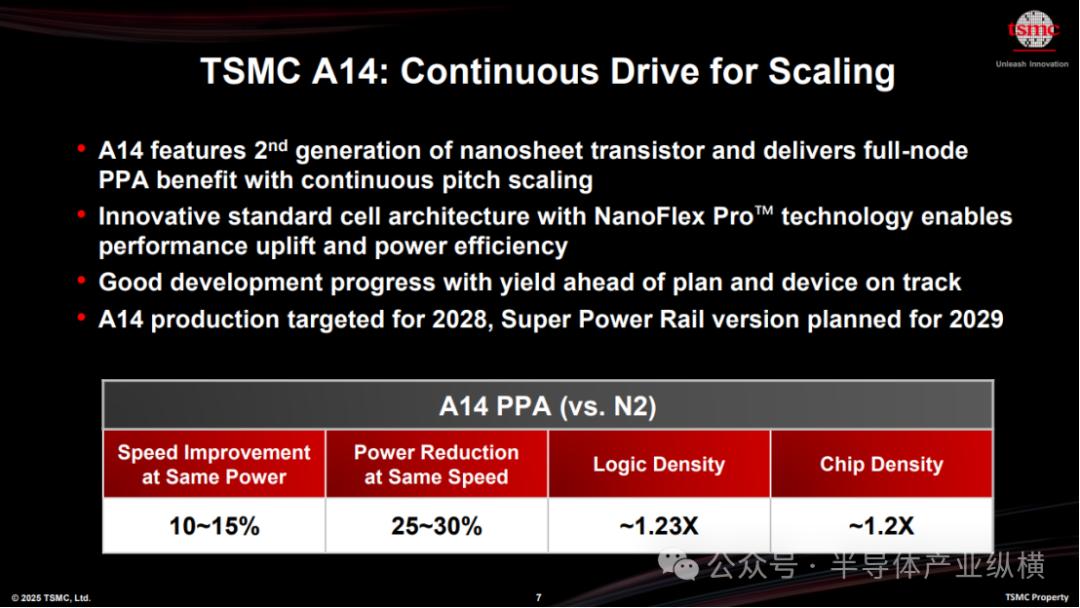
全新A14工艺技术的推出是本次研讨会的一大亮点。A14工艺是基于第二代GAA晶体管技术(NanoFLEX晶体管架构)的重大突破,基于台积电领先行业的N2(2nm)工艺,提供更快的运算和更好的能源效率。(AI)转型,还有望增强端侧AI功能,加强智能手机等应用。A14预计将于2028年开始大规模生产,到目前为止进展顺利,良率表现优于预期。
先进封装与系统集成创新
先进封装领域 , 台积电 还发布了许多重要信息。
台积电推出了包括CoWoSoSoSoWoSoSoSoc在内的3DFabric平台,这是一套全面的2.5D和3D集成技术。(Chip-on-Wafer-on-Substrate,晶片上芯片再到基板)、InFO(Integrated Fan-Out,集成式风扇)和SoIC(System on Integrated Chips,集成芯片系统)。该平台旨在克服传统单片设计的扩展限制,支持基于小芯片、高带宽内存集成和异构系统改进的结构。
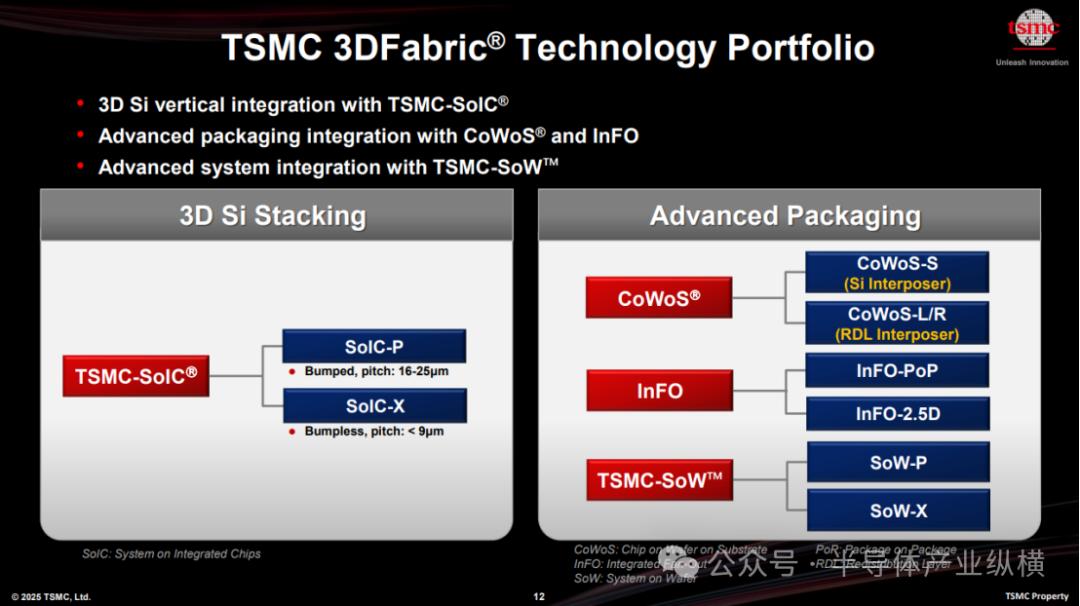
左边是堆叠或芯片级/晶圆级集成的选项。SoIC-选择微凸块技术,可以将间隔降低到16μm。采用无沉孔技术(SoIC-X),可以达到几微米的距离。台积电最初选择9μm工艺,目前已投入6个投资μM量产,并进一步改进,从而实现类似单片的集成密度。
对2.5/3D集成,有许多选择。晶圆芯片(CoWoS)该技术不仅支持普通硅中介层,还支持CoWoS-L,后一种是利用有机中介层与局部硅桥进行高密度连接。CoWos-R提供纯有机中介层。
集成扇出(InFO)技术在2016年首次应用于移动应用。这个平台现在已经扩展到支持汽车应用。
自2020年以来,台积电晶圆系统集成技术(InFO-SoW)在Cerebras和特斯拉等公司的尖端产品中得到了成功的应用,其中特斯拉Dojo超级计算机配备的晶圆级Cpu是该技术的标志性产品。晶圆级设计通过直接在整个硅晶圆上构建Cpu,实现了前所未有的核心间通信速度、性能密度和能效。但其复杂性和成本也相应增加,限制了广泛应用。
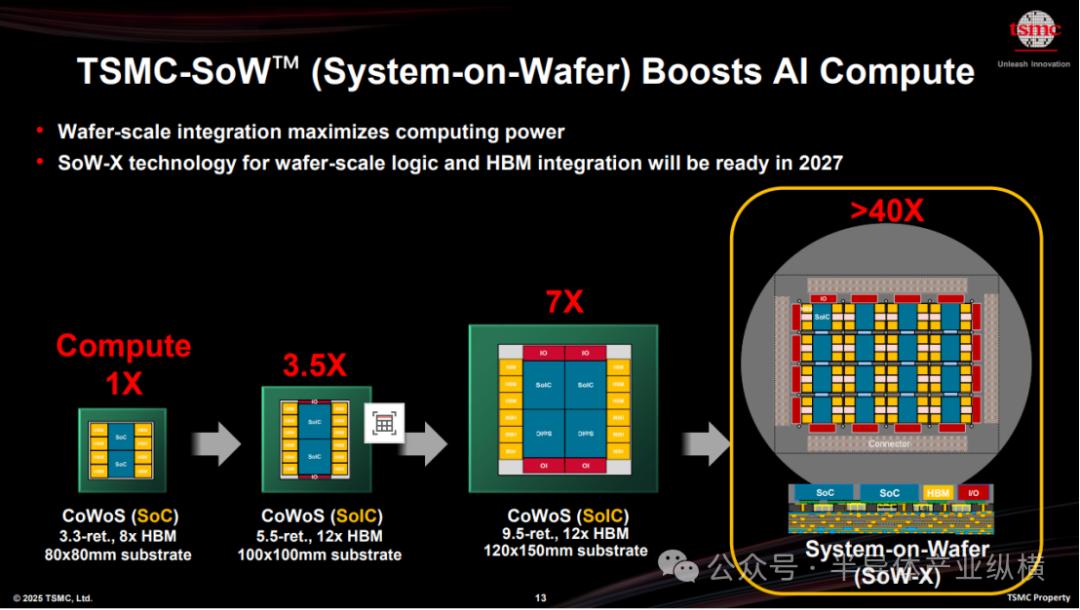
还有更新的晶圆系统(TSMC-SoW)封装。该技术将集成规模扩展到晶圆级别。其中之一就是先芯片(SoW-P)方法,将芯片放在晶圆上,然后构建集成RDL将芯片连接在一起。另外一个是后芯片(SoW-X)方法,即先在晶圆级建立中介层,然后将芯片放在晶圆上。最终实现了比标准光罩尺寸大40倍的设计方法。
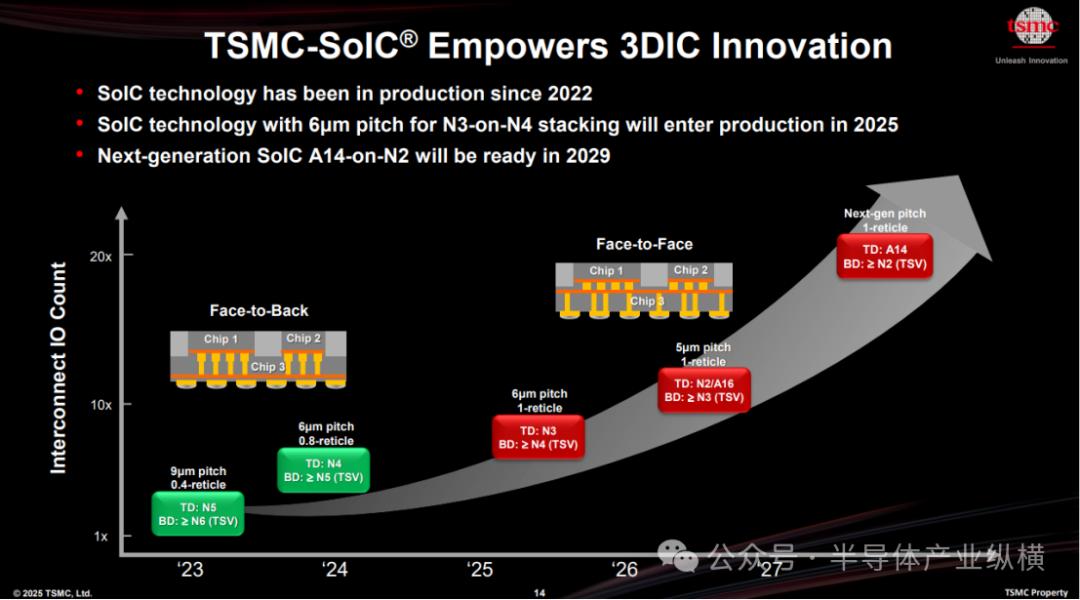
台积电的SoIC(集成芯片系统)技术在持续摩尔定律中起着关键作用。它采用基于小芯片的结构,结合高密度3D异构集成,而不是传统的单片缩放。SoIC作为台积电3DFabric平台的基石之一,实现了无基板3D堆叠,允许不同节点、功能和材料的裸片通过高密度连接进行垂直集成。
台积电提供的图表还展示了当今典型的人工智能加速器应用程序,该应用程序通过硅中介层将单片SoC和HBM存储器集成在一起。

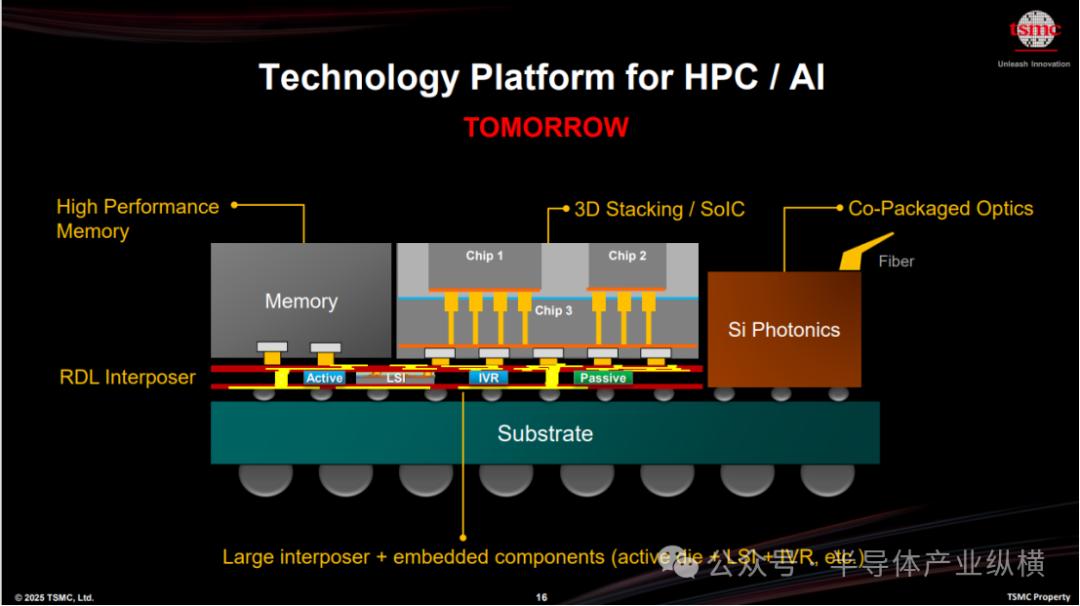
台积介绍了其他一系列高性能集成解决方案,包括N12和N3工艺逻辑基础裸晶,用于HBM4。(Base Die)、SiPh硅光子整合采用COUPE紧凑通用光子发动机技术。
特别是在内存集成方面,台积电特别强调CoW-SoW在HBM4(第四代高带宽内存)上的潜力。凭借其2048位超宽接口,HBM4有望处理AI和HPC工作负载对高带宽、低延迟内存的迫切需求,并与逻辑芯片紧密集成。这种集成方式不仅大大提高了数据传输速度,而且有效降低了功耗,为计算密集型应用的持续增长提供了理想的解决方案。
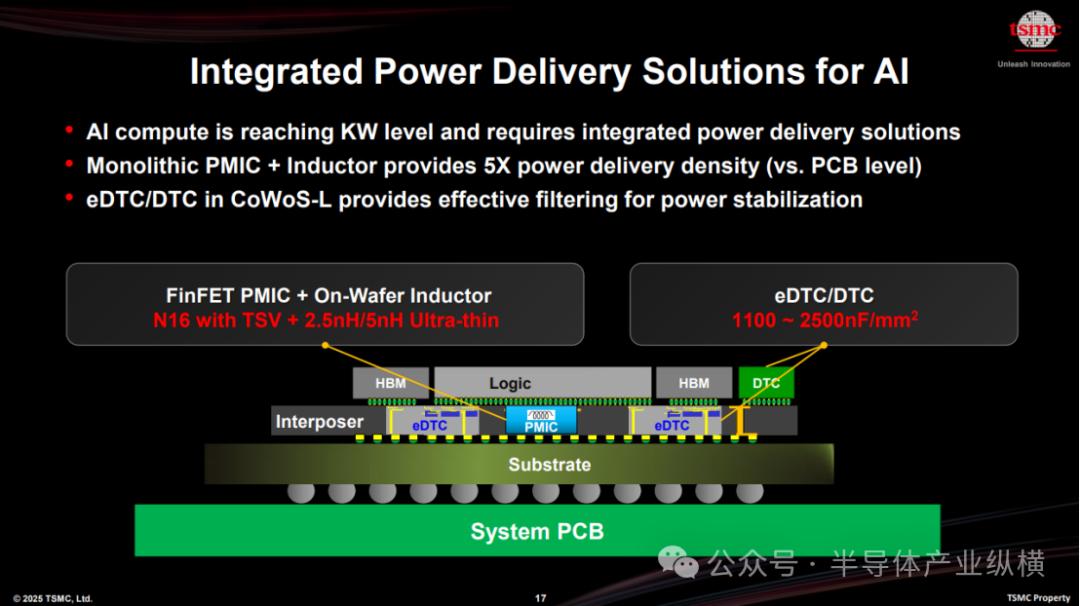
关于功率提升,未来的AI加速器可能需要1000多瓦的功率,这对封装中的功率传输提出了巨大的挑战。集成稳压器将有助于解决这些问题。台积电开发了一种高密度电感器,这是开发这种稳压器所需要的关键部件。因此,单片PMIC和电感器可以提供5倍的功率传输密度(与PCB相比)。
未来应用前景
另外,还有许多需要先进封装技术支持的创新应用。

增强现实眼镜就是一个新产品的例子,这类设备所需的部件包括超低功耗Cpu、高分辨率摄像头用于AR感知,内嵌式非易失性存储器用于代码存储。(eNVM)、大型主Cpu用于空间计算。、近眼显示引擎,WiFi/蓝牙用于低延迟射频,数字密集型电池管理集成电路用于低功耗充电。(PMIC)。该产品将为复杂性和效率设定新的标准。

虽然无人驾驶汽车备受关注,但人形机器人的需求也备受关注。它需要大量先进的硅片。将所有这些芯片集成到高密度、高能效的包装中的能力也很重要。
本文来自微信公众号“半导体产业纵横”(ID:ICViews),作者:ICVIEWS编辑部,36氪经授权发布。
本文仅代表作者观点,版权归原创者所有,如需转载请在文中注明来源及作者名字。
免责声明:本文系转载编辑文章,仅作分享之用。如分享内容、图片侵犯到您的版权或非授权发布,请及时与我们联系进行审核处理或删除,您可以发送材料至邮箱:service@tojoy.com




